台积电进军硅光市场少年派演员表 ,制定12.8Tbps封装互联路线图
台积电的紧凑型通用光子引擎 (COUPE:Compact Universal Photonic Engine) 使用该公司的 SoIC-X 封装技术将电子集成电路堆叠在光子集成电路 (EIC-on-PIC:electronics integrated circuit on photonic integrated circuit ) 上。该代工厂表示,使用其 SoIC-X 可以实现芯片间接口的最低阻抗,从而实现最高的能源效率。EIC 本身采用 65 纳米级工艺技术生产。

TSMC 的第一代 3D 光学引擎(或 COUPE)将集成到运行速度为 1.6 Tbps 的 OSFP 可插拔设备中。这个传输速率远远领先于当前的铜以太网标准(最高可达 800 Gbps),凸显了光学互连对于密集网络计算集群的直接带宽优势,更不用说预期的节能效果了。
展望未来,第二代 COUPE 旨在作为与开关共同封装的光学器件集成到 CoWoS 封装中,从而将光学互连带到主板级别。与第一个版本相比,该版本 COUPE 将支持高达 6.40 Tbps 的数据传输速率,并减少了延迟。
TSMC 的第三代 COUPE(运行在 CoWoS 内插器上的 COUPE)预计将进一步改进,将传输速率提高到 12.8 Tbps,同时使光学连接更接近处理器本身。目前,COUPE-on-CoWoS正处于开发探路阶段,台积电尚未设定目标日期。
最终,与许多业内同行不同的是,台积电迄今为止尚未参与硅光子市场,而将这一市场留给了 GlobalFoundries 等公司。但凭借3D光学引擎战略,该公司将进入这个重要市场,以弥补失去的时间。
台积电推出基于硅光子学的人工智能芯片封装平台
在 2024 年 IEEE 国际固态电路会议 (ISSCC) 上发布的一项开创性声明中,台积电(台湾积体电路制造公司)推出了一种基于硅光子的封装,有望彻底改变高性能计算和 AI 芯片设计。
台积电的创新方法利用硅光子技术,有望解决互连和电源方面的关键挑战,同时为人工智能加速器和其他先进计算应用的前所未有的性能增强铺平道路。
传统上,人工智能加速器对更高性能的需求需要集成更高带宽内存 (HBM) 和小芯片,从而导致中介层和晶圆基板上芯片配置的复杂性。
这些复杂性通常会导致互连和电源问题,从而限制芯片的可扩展性和效率。然而,台积电的新封装技术通过采用硅光子学引入了范式转变,其中光纤取代了传统的 I/O 进行数据传输。
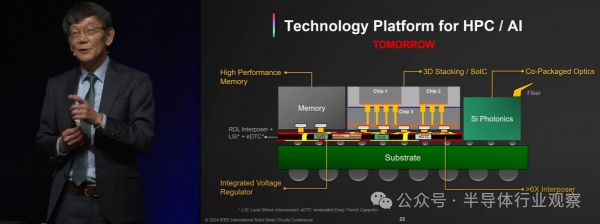
这种创新方法不仅增强了互连性,而且减轻了与传统中介层设计相关的挑战。
想象一下,您正在组织一次大型会议,演讲者来自不同领域。传统上,每个扬声器都有自己的麦克风和一组连接到主音响系统的电缆。
随着添加更多扬声器和麦克风,舞台上的电线变得杂乱,导致混乱和潜在的技术问题。这种设置代表了传统芯片封装的挑战,在传统芯片封装中添加更多组件会导致复杂的互连问题。
想象一下,如果您不使用单独的麦克风和电缆,而是实施依靠红外光束传输音频信号的尖端无线麦克风系统。每个扬声器都可以在舞台上自由移动,无需束缚电缆,音质保持清脆清晰。该无线系统代表了台积电的新封装技术,该技术利用硅光子学通过光纤而不是传统的电气路径传输数据。
此外,将会议舞台视为一个多层平台,扬声器相互堆叠,以在同一空间容纳更多演示者。借助无线麦克风系统,您可以轻松堆叠扬声器,而无需担心电缆管理问题或信号干扰。同样,台积电的封装技术允许将异构芯片堆叠在一起,从而最大限度地提高空间效率,并将更多组件集成到单个芯片上。
此外,想象一下将电源管理系统直接集成到麦克风支架中,确保每个扬声器都能获得一致且可靠的电源,而无需外部电源。这种集成电源管理系统反映了台积电在其封装技术中包含集成稳压器的方法,该方法优化了堆叠组件的电力传输,从而提高了效率和可靠性。
台积电封装技术的主要特点之一是能够在基础芯片上堆叠异构芯片,从而实现前所未有的集成度和性能水平。
通过利用混合键合技术,台积电最大限度地提高了堆叠芯片的 I/O 功能,进一步增强了连接性和数据吞吐量。
此外,这种方法允许将包括芯片和 HBM 在内的各种组件无缝集成到中介层上,该中介层可能是本地硅中介层。
其结果是一个紧凑且高效的封装解决方案,能够满足现代计算架构的需求。
为了解决供电这一关键问题,台积电的封装平台集成了一个集成稳压器,确保向堆叠组件提供稳定、高效的电力传输。
通过将电压调节功能直接集成到封装架构中,台积电无需外部电压调节器,从而降低了复杂性并增强了整体系统的可靠性。
这种创新方法不仅提高了功效,还增强了芯片的可扩展性,从而可以集成日益复杂的计算架构。
也许台积电封装技术最引人注目的方面是其通过 3D 封装实现万亿晶体管 AI 芯片的潜力。
然而,当今最先进的芯片可以容纳多达 1000 亿个晶体管,台积电的 3D 封装技术有望以指数方式提高这一限制。
通过堆叠多层异构芯片并利用先进的封装技术,台积电为人工智能加速器和其他高性能计算应用提供前所未有的计算能力和效率水平。
台积电推出基于硅光子的封装平台是高性能计算和人工智能芯片设计进步的一个重要里程碑。
通过解决互连性、电源和可扩展性方面的关键挑战,台积电的创新方法有望释放现代计算架构的全部潜力。
台积电的封装技术能够实现万亿晶体管人工智能芯片并促进各种组件的无缝集成,有望推动半导体行业的下一波创新浪潮,开创前所未有的性能和效率的新时代。
附:台积电北美峰会演讲PPT

下一篇: 北京车展的泼天流量,被这个男人半路截胡了









